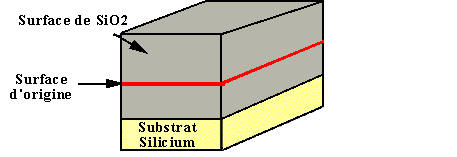
II) Oksidointi
Oksidi voidaan saada aikaan usealla eri tekniikalla:
- terminen (kuiva)oksidointi hapen avulla,
- terminen märkäoksidointi hapen ja vesihöyryn avulla,
- terminen höyryoksidointi vesihöyryn avulla,
- anodinen oksidointi saadaan aikaan sähkökemiallisesti,
- plasmaoksidointi toteutetaan happiplasman avulla .
Jatkossa erotetaan tekninen oksidointi oksidikerrostumasta, joka ei saa aikaan samaa lämpöjännitystä.
Oksidoinnissa pii hapetetaan alustan pinnalta alkaen. Pääreaktiot ovat: :
Si kiinteä + O2 ---> SiO2 kiinteä
Si kiinteä + 2 H2O ---> SiO2 kiinteä+ 2H2
Jotta saadaan aikaan tyydyttävän sähköisen laadun täyttävä oksidi, suositaan termistä oksidointia joko hapella tai vesihöyryllä. Pelkällä hapella oksidi muodostuu hitaammin, mutta elektroninen laatu on parempi (vähän elektronisesti aktiivisia virheatomeja). Oksidoitaessa vesihöyryllä oksidi muodostuu nopeammin, mutta elektronisia virheitä on enemmän. Menetelmää kannattaa käyttää, kun valmistetaan paksuja kalvoja tai eristäviä oksidikerroksia (paksuus joitakin tuhansia Ångströmejä).
Pii oksidoituu huoneenlämmössä myös ilmassa siinä olevan hapen johdosta. Oksidikerroksen saavuttaessa kaksi tai kolme atomikerrosta, oksidoituminen kuitenkin loppuu. Sanotaan, että kerros passivoi. Paksun oksidikerroksen saamiseksi reaktiota pitää aktivoida nostamalla lämpötilaa.
Piikerros reagoi alussa oksidoivan aineen kanssa muodostaakseen SiO2:ta. Ensin kulutetaan siis pii. Si/SiO2 –yhdiste päätyy alkuperäisen pinnan ”alapuolelle”. Yksinkertaisen laskutoimituksen perusteella selviää, että 46 prosenttia oksidin kokonaispaksuudesta sijoittuu alkuperäiskerroksen alle ja 54 prosenttia kerroksen päälle (kuva 37).
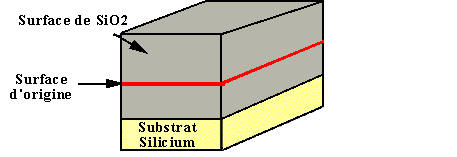
Kuva 37: Piin oksidointi. Osa alustasta on kulunut oksidoinnin aikana. (S.M. Sze [2]).
Alustan koon kasvu vaikuttaa merkittävästi levyn pinnan tasaisuuteen, kun toteutetaan paikallinen oksidointi. Kasvu on paikallista ja se synnyttää kuvassa 38 näkyvän kerroksen.

Kuva 38: Piin paikallisen oksidoinnin vaikutus. Alustan kasvu saa aikaan oksidikerroksen levyn pinnalle.
Oksidointiprosessit toteutetaan yleensä samanlaisissa uuneissa kuin diffuusio. Niissä kierrätetään kuivaa tai kosteaa happea tai vesihöyryä (kuva 39).
Vesihöyryä voidaan kehittää myös uunissa vetyvirran ja happivirran synteesillä. Koska reaktio luovuttaa paljon lämpöä, se on vaarallinen. Laitteessa on runsaasti varoittimia räjähdyksen välttämiseksi (liekinvalvoja, virtauksen valvoja jne.) Tällaista reaktoria käytetään pääasiassa teollisuudessa. Täytyy muistaa, että käytettyjen kaasujen kemiallisen puhtauden on oltava erittäin hyvä (puhtaus vähintään 5,0 ppm eli epäpuhtauksien kokonaismäärä vähemmän kuin 10 ppm).
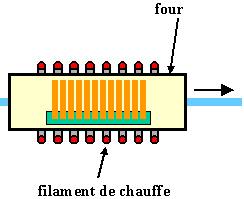 |
|
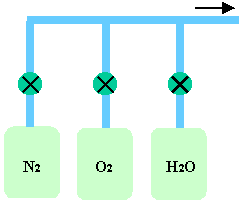 |
Kuva 39: Lämpöoksidointi hapella ja vesihöyryllä. Vesihöyryä voidaan valmistaa myös palavasta vetyliekistä ja hapesta (vesihöyryoksidointi).