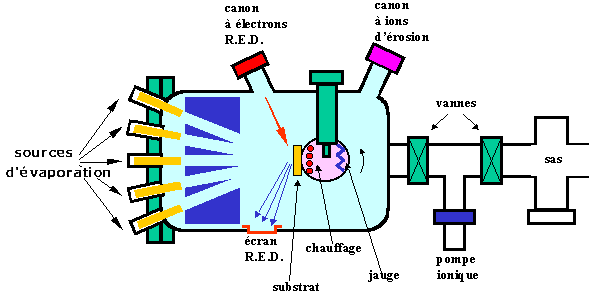
III) Les méthodes expérimentales :
Il existe principalement 3 types de méthodes expérimentales.
- l'épitaxie
par jet moléculaire, EJM ou MBE (Molecular Beam Epitaxy), - l'épitaxie en phase liquide ou LPE (Liquid Phase
Epitaxy),
Pour chacune de ces techniques, des appareillages spécifiques sont mis en œuvre.
L'épitaxie par jet moléculaire
Cette technique consiste à envoyer des molécules à la surface d'un substrat dans un vide très poussé afin d'éviter tout choc ou contamination sur le parcours. Le principe de la source est l'évaporation sous vide (cellule de Knudsen) par chauffage. Les sources d'évaporation peuvent être de nature et de dopage différents ; pour chaque élément évaporé, il faut adapter la puissance de chauffe de cellules mais aussi du porte-substrat. Par le contrôle des cellules d'évaporation, on crée un jet de molécules en direction du substrat ; on peut ainsi réaliser couche par couche des structures très complexes telles que les super réseaux, les diodes laser, les transistors à forte mobilité d'électron (HEMT). On obtient ainsi une très grande précision de croissance, des jonctions très abruptes, mais cette opération est très lente et ne concerne qu'un seul substrat à la fois. La vitesse de croissance est de l'ordre de 1nm par minute. Cette technique est donc très coûteuse et ne concerne que des dispositifs à très forte valeur ajoutée.
Ce système ultravide, 10-10 Torr, permet tous les contrôles et les caractérisations in-situ dont les principes nécessitent un vide poussé : diffraction d'électrons, spectroscopie Auger, ESCA (XPS ou UPS), diffraction des rayons X, etc... On peut ainsi, en permanence, vérifier la cristallinité du cristal en cours de croissance.
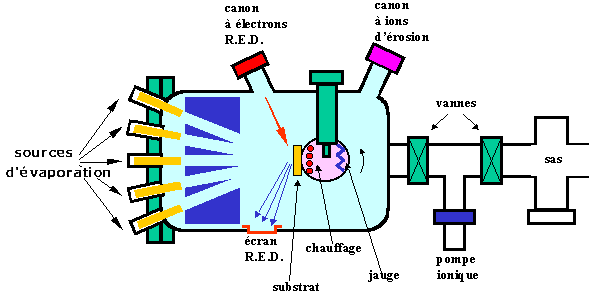
Figure 16 : Bâti d'épitaxie par jet moléculaire, EJM, ou Molecular Beam Epitaxy, MBE (d'après D.V Morgan et K. Board [3]).
L'épitaxie en phase liquide
Cette technique consiste à faire croître le cristal par la mise en contact du substrat avec une source liquide. C'est le même principe que le tirage d'un lingot par la méthode Czochralski. Il faut bien contrôler les échanges thermiques pour éviter de liquéfier le cristal existant. Cette méthode présente l'avantage d'être très rapide, la vitesse de croissance peut être de l'ordre du micron par minute mais bien sûr n'a pas du tout la même précision que l'EJM.
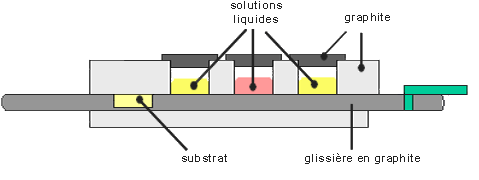
Figure 17 : Dispositif multibain d'épitaxie en phase liquide. Les solutions peuvent être de matériau ou de dopage différents pour réaliser une hétéroépitaxie (par exemple un hétérotransistor bipolaire).
L'épitaxie en phase vapeur (VPE ou CVD)
Cette opération consiste à faire croître le cristal à partir de sources de gaz contenant les éléments dopants. Dans le réacteur, les gaz se dissocient pour fournir par exemple le silicium qui se dépose à la surface des plaquettes. Pour assurer une bonne croissance ces dernières sont chauffées. Nous verrons dans la suite que suivant la température de croissance, les réactions mises en jeu sont très différentes et qu'elles peuvent même conduire à des effets négatifs. Il faudra donc aussi contrôler les équilibres chimiques par injections de gaz résultant de la décomposition de la source. Nous allons donner, ci-dessous, plus d'information sur ces différentes réactions.
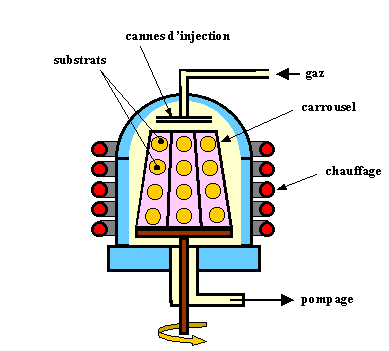
Figure 18 : Banc d'épitaxie en phase vapeur. Les gaz injectés contiennent en général du trichlorosilane, du HCl et de l'hydrogène.
Procédés d'épitaxie en phase vapeur du silicium
Il existe différents types de procédés d'épitaxie du Silicium suivant la source de silicium qui peut être du SiCl4, SiHCl3, du SiH2Cl2 et du SiH4.
1) à partir du tétrachlorosilane, SiCl4, la réaction est :
SiCl4
gaz + 2H2
gaz ![]() Si sol + 4HCl
gaz
Si sol + 4HCl
gaz
Elle s'effectue en général autour de 1250°C, ce qui entraîne durant l'épitaxie une redistribution importante des dopants.
2) à partir de trichlorosilane, SiHCl3, la réaction est :
SiHCl3
gaz + H2 gaz ![]() Si sol + 3HCl gaz
Si sol + 3HCl gaz
Elle s'effectue en général autour de 1100°C ; c'est la méthode industrielle la plus utilisée actuellement.
3) à partir de la pyrolyse du dichlorosilane, SiH2Cl2 , la réaction est :
SiH2
Cl2
gaz ![]() Si sol + 2HCl gaz
Si sol + 2HCl gaz
Cette réaction permet d'obtenir une bonne qualité du cristal avec une vitesse de dépôt relativement élevée.
L'ensemble des trois méthodes ci-dessus présente l'inconvénient de produire de l'acide chlorhydrique qui peut attaquer le silicium en cours de croissance. Par contre, on peut jouer sur la pression partielle de ce composé pour contrôler la croissance.
La réaction de pyrolyse du silane est une réaction irréversible :
SiH4 gaz -> Si sol + 2H2 gaz
Cette réaction s'effectue à 1000°C sans composés chlorés. Cette technique permet de réaliser des jonctions abruptes puisque la température n'est pas très élevée, mais le silane est un produit coûteux et dangereux (il s'enflamme instantanément à l'air libre) et la vitesse de dépôt est faible.