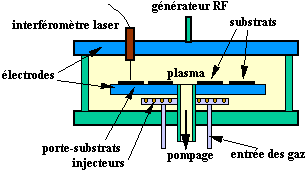
III) La gravure sèche :
La gravure sèche est en réalité une technique de gravure plasma dans laquelle interviennent à la fois les effets de bombardement par des ions et la réaction chimique. On la dénomme R.I.E. (Reactive Ion Etching en anglais).
Le réacteur ressemble au réacteur de dépôt à platine porte-substrats horizontale, mais les gaz injectés sont dans ce cas destinés à graver la couche de surface (figure suivante). De la même façon, on utilise un générateur radiofréquence qui va permettre de générer dans le réacteur les espèces réactives.
Sans polarisation particulière des électrodes, l'attaque est en général isotropique, c'est-à-dire identique suivant toute les directions. Cependant, lorsque les matériaux à graver ont des orientations préférentielles, c'est le cas des cristaux semiconducteurs, la gravure peut se faire préférentiellement suivant des plans réticulaires ou axes cristallographiques.
Le réacteur est en général équiper d'un système de contrôle de gravure ou plus exactement de fin de gravure. Il s'agit d'un interféromètre à laser dont la période du signal détecté change lors d'un changement d'espèces gravées.
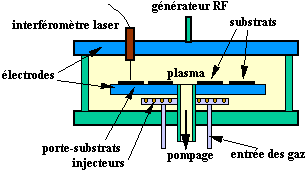
Figure 54 : Réacteur de gravure plasma à platine porte-substrats horizontale. Ce réacteur est de conception très similaire à celui de dépôt plasma de la figure 48 (d'après S.M. Sze [5]).
Le principe du procédé, représenté figure 55, est résumé comme suit :
- génération dans le plasma des espèces pouvant attaquer chimiquement la couche,
- transfert des espèces réactives depuis le plasma vers la surface de la couche à graver,
- adsorption de l'espèce attaquante à la surface,
- réaction avec la matériau de surface. Le matériau produit par la réaction doit être volatile pour pouvoir quitter la surface,
- désorption du produit de réaction,
- diffusion dans l'environnement gazeux.
Si toutes ces conditions sont remplies, on peut alors espérer avoir un bonne gravure plasma. Notons que pour la mise au point de cette étape technologique, la difficulté est de générer des espèces volatiles après réaction en surface.

Figure 55 : Schéma de principe de la réaction de gravure plasma. Pour que la gravure soit efficace, il faut éliminer les produits de réaction.
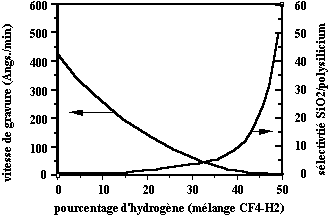
Figure 56 : Vitesse de gravure et sélectivité pour une gravure plasma utilisant du tétrafluorure de carbone dilué dans de l'hydrogène. En fonction de la dilution la sélectivité est modifiée. Elle sera ajustée en fonction des besoins (d'après L.M. Ephrath, [12]).
Suivant les espèces introduites dans le réacteur et suivant la nature de la couche à graver la vitesse d'attaque sera différente. Il faudra jouer sur la différence des vitesses pour s'assurer d'un bon contrôle de la gravure.
La précision notamment sur la fin de gravure sera d'autant meilleure que la sélectivité sera importante. En effet, il faut pouvoir graver, par exemple, un oxyde sans pour autant éliminer la couche sous-jacente qui peut être, par exemple, la source d'un transistor. On peut aussi éliminer la couche de silicium polycristallin sur un oxyde. En réglant la proportion des gaz réactifs, on ajuste la sélectivité de la gravure du SiO2 par rapport au polysilicium.

Figure 57 : Vitesse de gravure verticale et horizontale. La différence entre ces deux vitesses due au bombardement d'ions suivant l'orientation verticale, permet de réaliser une gravure anisotropique.
Un réglage astucieux entre l'énergie des ions incidents issus du plasma et le flux des ions chimiquement actifs permet d'obtenir des gravures soit isotropiques soit anisotropiques (figure 57).
En effet, en accélérant les ions par une polarisation continue entre les deux électrodes, on peut accélérer les ions réactifs en leur donnant une orientation préférentielle en direction de la surface. La gravure est alors anisotropique. La figure 4 montre l'anisotropie obtenue en ajoutant un bombardement d'ions qui augmente la vitesse de gravure verticale. On joue ainsi sur la compétition entre le bombardement ionique et l'attaque chimique.
Ce type de gravure est particulièrement intéressant dans le cas où l'on veut réaliser des espaceurs de très faible dimension dans les technologies autoalignées. Ce qui peut représenter, a priori, un inconvénient, est exploité astucieusement, pour aller au-delà des limites optiques en précision des motifs (figure 58). En effet, du fait que l'on contrôle parfaitement bien la croissance et donc l'épaisseur des couches, on peut créer des résidus ou espaceurs de largeur très faible, en rapport avec les épaisseurs. On peut ainsi créer des nouveaux "masques d'implantation" dont l'ouverture est par exemple de 0,2 micron plus large ou plus étroit que le préexistant. Cela sera notamment utilisé pour fabriquer des transistors submicroniques à drain doublement dopé (deux zones de dopage différents).
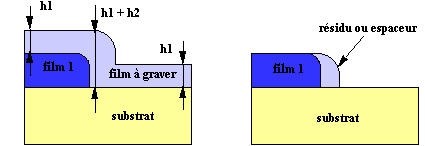
Figure 58 : réalisation d'espaceurs par utilisation d'un gravure anisotropique (d'après S.M. Sze [5])
Les principaux gaz utilisés dans les gravures sèches sont indiqués dans le tableau suivant :
Matériau à graver |
Silicium |
SiO2 |
Siliciure |
SF6 |
CHF3 |
CFCl3 |
|
gaz |
CF4 + O2 |
CF4 + O2 |
CF2Cl2 |
HF |
CF4 + H2 |
CCl4 |
|
CFCl3 |
SiCl4 |
SF6 |
En pratique, la différence entre gravure isotropique et anisotropique peut être représentée sur la figure 59. Il faudra tenir compte de la gravure latérale plus importante dans le cas de la gravure humide. Il est clair que pour les motifs de très petite dimension, il sera préféré une gravure anisotropique.
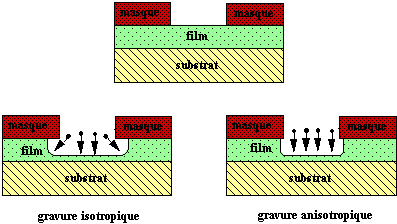
Figure 59 : Différence entre gravure isotropique et anisotropique. La largeur du motif gravé sera différente.